
給大家說說芯片測試相關。1測試在芯片産業價值鏈上的位置如下面這個圖表,一顆芯片最終做到終端産品上,一般需要經過芯片設計、晶圓制造、晶圓測試、封裝、成品測試、闆級封裝等這些環節。在整個價值鏈中,芯片公司需要主導的環節主要是芯片設計和測試,其餘的環節都可以由相應的partner來主導或者完成。
芯片測試科普
給大家說說芯片測試相關。1測試在芯片産業價值鏈上的位置如下面這個圖表,一顆芯片最終做到終端産品上,一般需要經過芯片設計、晶圓制造、晶圓測試、封裝、成品測試、闆級封裝等這些環節。在整個價值鏈中,芯片公司需要主導的環節主要是芯片設計和測試,其餘的環節都可以由相應的partner來主導或者完成。 圖(1) 2測試如何體現在設計的過程中 下圖表示的是設計公司在進行一個新的項目的時候的一般流程,從市場需求出發,到産品tape out進行制造,包含了系統設計、邏輯設計、電路設計、物理設計,到最後開始投入制造。最下面一欄标注了各個設計環節中對于測試的相關考慮,從測試架構、測試邏輯設計、測試模式産生、到各種噪聲/延遲/失效模式綜合、進而産生測試pattern,最後在制造完成後進行測試,對測試數據進行分析,從而分析失效模式,驗證研發。所以,測試本身就是設計,這個是需要在最初就設計好了的,對于設計公司來說,測試至關重要,不亞于電路設計本身。
2測試如何體現在設計的過程中 下圖表示的是設計公司在進行一個新的項目的時候的一般流程,從市場需求出發,到産品tape out進行制造,包含了系統設計、邏輯設計、電路設計、物理設計,到最後開始投入制造。最下面一欄标注了各個設計環節中對于測試的相關考慮,從測試架構、測試邏輯設計、測試模式産生、到各種噪聲/延遲/失效模式綜合、進而産生測試pattern,最後在制造完成後進行測試,對測試數據進行分析,從而分析失效模式,驗證研發。所以,測試本身就是設計,這個是需要在最初就設計好了的,對于設計公司來說,測試至關重要,不亞于電路設計本身。  圖(2)設計公司主要目标是根據市場需求來進行芯片研發,在整個設計過程中,需要一直考慮測試相關的問題,主要有下面幾個原因:1) 随着芯片的複雜度越來越高,芯片内部的模塊越來越多,制造工藝也是越來越先進,對應的失效模式越來越多,而如何能完整有效地測試整個芯片,在設計過程中需要被考慮的比重越來越多。2) 設計、制造、甚至測試本身,都會帶來一定的失效,如何保證設計處理的芯片達到設計目标,如何保證制造出來的芯片達到要求的良率,如何确保測試本身的質量和有效,從而提供給客戶符合産品規範的、質量合格的産品,這些都要求必須在設計開始的第一時間就要考慮測試方案。3) 成本的考量。越早發現失效,越能減少無謂的浪費;設計和制造的冗餘度越高,越能提供最終産品的良率;同時,如果能得到更多的有意義的測試數據,也能反過來提供給設計和制造端有用的信息,從而使得後者有效地分析失效模式,改善設計和制造良率。 3測試的各種
圖(2)設計公司主要目标是根據市場需求來進行芯片研發,在整個設計過程中,需要一直考慮測試相關的問題,主要有下面幾個原因:1) 随着芯片的複雜度越來越高,芯片内部的模塊越來越多,制造工藝也是越來越先進,對應的失效模式越來越多,而如何能完整有效地測試整個芯片,在設計過程中需要被考慮的比重越來越多。2) 設計、制造、甚至測試本身,都會帶來一定的失效,如何保證設計處理的芯片達到設計目标,如何保證制造出來的芯片達到要求的良率,如何确保測試本身的質量和有效,從而提供給客戶符合産品規範的、質量合格的産品,這些都要求必須在設計開始的第一時間就要考慮測試方案。3) 成本的考量。越早發現失效,越能減少無謂的浪費;設計和制造的冗餘度越高,越能提供最終産品的良率;同時,如果能得到更多的有意義的測試數據,也能反過來提供給設計和制造端有用的信息,從而使得後者有效地分析失效模式,改善設計和制造良率。 3測試的各種
對于芯片來說,有兩種類型的測試,抽樣測試和生産全測。抽樣測試,比如設計過程中的驗證測試,芯片可靠性測試,芯片特性測試等等,這些都是抽測,主要目的是爲了驗證芯片是否符合設計目标,比如驗證測試就是從功能方面來驗證是否符合設計目标,可靠性測試是确認最終芯片的壽命以及是否對環境有一定的魯棒性,而特性測試測試驗證設計的冗餘度。這裏我們主要想跟大家分享一下生産全測的測試,這種是需要100%全測的,這種測試就是把缺陷挑出來,分離壞品和好品的過程。這種測試在芯片的價值鏈中按照不同階段又分成晶圓測試和最終測試(FT,也叫封裝測試或者成品測試),就是上面圖(1)中的紅色部分。 測試相關的各種名詞:ATE-----------Automatic Test Equipment,自動化測試設備,是一個高性能計算機控制的設備的集合,可以實現自動化的測試。Tester---------測試機,是由電子系統組成,這些系統産生信号,建立适當的測試模式,正确地按順序設置,然後使用它們來驅動芯片本身,并抓取芯片的輸出反饋,或者進行記錄,或者和測試機中預期的反饋進行比較,從而判斷好品和壞品。Test Program---測試程序,測試機通過執行一組稱爲測試程序的指令來控制測試硬件DUT-----------Device Under Test,等待測試的器件,我們統稱已經放在測試系統中,等待測試的器件爲DUT。 晶圓、單顆die和封裝的芯片----如下面圖(3)所示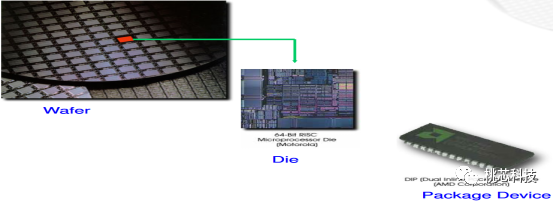 圖(3)Wafer就是晶圓,這個由Fab進行生産,上面規則地放着芯片(die),根據die的具體面積,一張晶圓上可以放數百數千甚至數萬顆芯片(die)。Package Device就是封裝好的芯片,根據最終應用的需求,有很多種形式,這個部分由芯片産業價值鏈中的封裝工廠進行完成。 測試系統的基本工作機制:
圖(3)Wafer就是晶圓,這個由Fab進行生産,上面規則地放着芯片(die),根據die的具體面積,一張晶圓上可以放數百數千甚至數萬顆芯片(die)。Package Device就是封裝好的芯片,根據最終應用的需求,有很多種形式,這個部分由芯片産業價值鏈中的封裝工廠進行完成。 測試系統的基本工作機制: 圖(4) 對測試機進行編寫程序,從而使得測試機産生任何類型的信号,多個信号一起組成測試模式或測試向量,在時間軸的某一點上向DUT施加一個測試向量,将DUT産生的輸出反饋輸入測試機的儀器中測量其參數,把測量結果與存儲在測試機中的“編程值”進行比較,如果測量結果在可接受公差範圍内匹配測試機中的“編程值”,那麽這顆DUT就會被認爲是好品,反之則是壞品,按照其失效的種類進行記錄。 晶圓測試(wafer test,或者CP-chip probering):就是在圖(3)中的晶圓上直接進行測試,下面圖中就是一個完整的晶圓測試自動化系統。Prober--- 與Tester分離的一種機械設備,主要的作用是承載wafer,并且讓wafer内的一顆die的每個bond pads都能連接到probe card的探針上,并且在測試後,移開之前的接觸,同時移動wafer,換另外的die再一次連接到probe card的探針上,并記錄每顆die的測試結果。
圖(4) 對測試機進行編寫程序,從而使得測試機産生任何類型的信号,多個信号一起組成測試模式或測試向量,在時間軸的某一點上向DUT施加一個測試向量,将DUT産生的輸出反饋輸入測試機的儀器中測量其參數,把測量結果與存儲在測試機中的“編程值”進行比較,如果測量結果在可接受公差範圍内匹配測試機中的“編程值”,那麽這顆DUT就會被認爲是好品,反之則是壞品,按照其失效的種類進行記錄。 晶圓測試(wafer test,或者CP-chip probering):就是在圖(3)中的晶圓上直接進行測試,下面圖中就是一個完整的晶圓測試自動化系統。Prober--- 與Tester分離的一種機械設備,主要的作用是承載wafer,并且讓wafer内的一顆die的每個bond pads都能連接到probe card的探針上,并且在測試後,移開之前的接觸,同時移動wafer,換另外的die再一次連接到probe card的探針上,并記錄每顆die的測試結果。 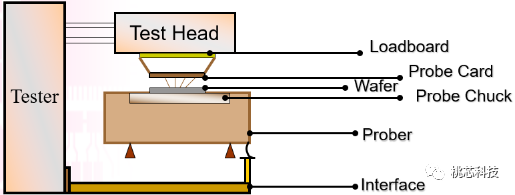 圖(4)Probe Card---乃是Tester與wafer上的DUT之間其中一個連接介面,目的在連接Tester Channel 與待測DUT。大部分爲鎢銅或铍銅,也有钯等其他材質;材質的選擇需要高強度、導電性及不易氧化等特性,樣子如下面圖(5)所示。
圖(4)Probe Card---乃是Tester與wafer上的DUT之間其中一個連接介面,目的在連接Tester Channel 與待測DUT。大部分爲鎢銅或铍銅,也有钯等其他材質;材質的選擇需要高強度、導電性及不易氧化等特性,樣子如下面圖(5)所示。 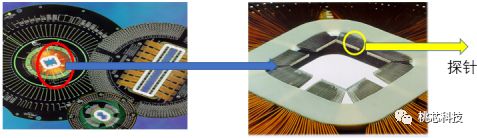 圖(5) 當 probe card 的探針正确接觸wafer内一顆 die的每個bond pads後, 送出start信号通過Interface給tester開始測試, tester完成測試送回分類訊号 ( End of test) 給Prober, 量産時必須 tester 與 prober 做連接(docking) 才能測試。 最終測試(FT,或者封裝測試):就是在圖(3)中的Package Device上進行測試.下圖就是一個完整的FT的測試系統。對比wafer test,其中硬件部分,prober換成了handler,其作用是一樣的,handler的主要作用是機械手臂,抓取DUT,放在測試區域,由tester對其進行測試,然後handler再根據tester的測試結果,抓取DUT放到相應的區域,比如好品區,比如壞品1類區,壞品2類區等。
圖(5) 當 probe card 的探針正确接觸wafer内一顆 die的每個bond pads後, 送出start信号通過Interface給tester開始測試, tester完成測試送回分類訊号 ( End of test) 給Prober, 量産時必須 tester 與 prober 做連接(docking) 才能測試。 最終測試(FT,或者封裝測試):就是在圖(3)中的Package Device上進行測試.下圖就是一個完整的FT的測試系統。對比wafer test,其中硬件部分,prober換成了handler,其作用是一樣的,handler的主要作用是機械手臂,抓取DUT,放在測試區域,由tester對其進行測試,然後handler再根據tester的測試結果,抓取DUT放到相應的區域,比如好品區,比如壞品1類區,壞品2類區等。  圖(6) 而probe card則換成了load board,其作用是類似的,但是需要注意的是load board上需要加上一個器件—Socket,這個是放置package device用的,每個不同的package種類都需要不同的socket,如下面圖(7)所示,load board上的四個白色的器件就是socket。
圖(6) 而probe card則換成了load board,其作用是類似的,但是需要注意的是load board上需要加上一個器件—Socket,這個是放置package device用的,每個不同的package種類都需要不同的socket,如下面圖(7)所示,load board上的四個白色的器件就是socket。 圖(7)Handler 必須與 tester 相結合(此動作叫 mount 機)及接上interface才能測試, 動作爲handler的手臂将DUT放入socket,然後 contact pusher下壓, 使 DUT的腳正确與 socket 接觸後, 送出start 訊号, 透過 interface 給 tester, 測試完後, tester 送回 binning 及EOT 訊号; handler做分類動作。4如何進行一個産品的測試開發各種規格書:通常有三種規格書,設計規格書、測試規格書、産品規格書。設計規格書,是一種包含新電路設計的預期功能和性能特性的定義的文檔,這個需要在設計項目啓動階段就要完成,通常由市場和設計人員共同完成,最終設計出來的産品的實際功能和性能需要和設計規格書的規定進行比較,以确認本次設計項目的完成度。測試規格書,其中包含詳細的逐步測試程序、條件、方法,以充分測試電路,通常由設計人員和産品驗證工程師在設計過程中完成。産品規格書,通常就是叫做datasheet,由設計公司對外發布的,包含了各種詳細的規格、電壓、電流、時序等信息。 測試計劃書:就是test plan,需要仔細研究産品規格書,根據産品規格書來書寫測試計劃書,具體的需要包含下面這些信息:a)DUT的信息,具體的每個pad或者pin的信息,CP測試需要明确每個bond pads的坐标及類型信息,FT測試需要明确封裝類型及每個pin的類型信息。b)測試機要求,測試機的資源需求,比如電源數量需求、程序的編寫環境、各種信号資源數量、精度如何這些,還需要了解對應的測試工廠中這種測試機的數量及産能,測試機費用這些。c)各種硬件信息,比如CP中的probe card, FT中的load board的設計要求,跟測試機的各種信号資源的接口。d)芯片參數測試規範,具體的測試參數,每個測試項的測試條件及參數規格,這個主要根據datasheet中的規範來确認。類型與下面圖(8)這樣
圖(7)Handler 必須與 tester 相結合(此動作叫 mount 機)及接上interface才能測試, 動作爲handler的手臂将DUT放入socket,然後 contact pusher下壓, 使 DUT的腳正确與 socket 接觸後, 送出start 訊号, 透過 interface 給 tester, 測試完後, tester 送回 binning 及EOT 訊号; handler做分類動作。4如何進行一個産品的測試開發各種規格書:通常有三種規格書,設計規格書、測試規格書、産品規格書。設計規格書,是一種包含新電路設計的預期功能和性能特性的定義的文檔,這個需要在設計項目啓動階段就要完成,通常由市場和設計人員共同完成,最終設計出來的産品的實際功能和性能需要和設計規格書的規定進行比較,以确認本次設計項目的完成度。測試規格書,其中包含詳細的逐步測試程序、條件、方法,以充分測試電路,通常由設計人員和産品驗證工程師在設計過程中完成。産品規格書,通常就是叫做datasheet,由設計公司對外發布的,包含了各種詳細的規格、電壓、電流、時序等信息。 測試計劃書:就是test plan,需要仔細研究産品規格書,根據産品規格書來書寫測試計劃書,具體的需要包含下面這些信息:a)DUT的信息,具體的每個pad或者pin的信息,CP測試需要明确每個bond pads的坐标及類型信息,FT測試需要明确封裝類型及每個pin的類型信息。b)測試機要求,測試機的資源需求,比如電源數量需求、程序的編寫環境、各種信号資源數量、精度如何這些,還需要了解對應的測試工廠中這種測試機的數量及産能,測試機費用這些。c)各種硬件信息,比如CP中的probe card, FT中的load board的設計要求,跟測試機的各種信号資源的接口。d)芯片參數測試規範,具體的測試參數,每個測試項的測試條件及參數規格,這個主要根據datasheet中的規範來确認。類型與下面圖(8)這樣 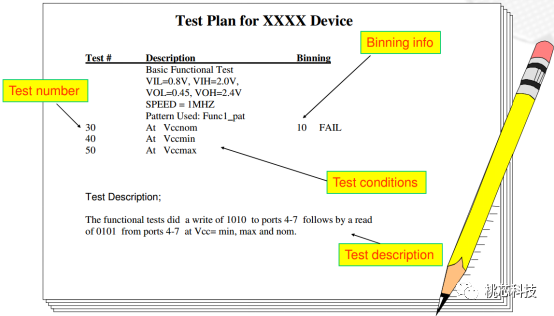 圖(8) e)測試項目開發計劃,規定了具體的細節以及預期完成日期,做到整個項目的可控制性和效率。 測試項目流程:桃芯科技目前量産的是BLE的SOC産品,裏面包含了eflash、AD/DA、 LDO/BUCK、RF等很多模塊,爲了提供給客戶高品質的産品,我們針對每個模塊都有詳細的測試,下面圖(9)是我們的大概的項目測試流程:
圖(8) e)測試項目開發計劃,規定了具體的細節以及預期完成日期,做到整個項目的可控制性和效率。 測試項目流程:桃芯科技目前量産的是BLE的SOC産品,裏面包含了eflash、AD/DA、 LDO/BUCK、RF等很多模塊,爲了提供給客戶高品質的産品,我們針對每個模塊都有詳細的測試,下面圖(9)是我們的大概的項目測試流程: 
Open/Short Test: 檢查芯片引腳中是否有開路或短路。
DC TEST: 驗證器件直流電流和電壓參數
Eflash TEST: 測試内嵌flash的功能及性能,包含讀寫擦除動作及功耗和速度等各種參數。
Function TEST: 測試芯片的邏輯功能。
AC Test: 驗證交流規格,包括交流輸出信号的質量和信号時序參數。
Mixed Signal Test: 驗證DUT數模混合電路的功能及性能參數。
RF Test: 測試芯片裏面RF模塊的功能及性能參數。











